极紫外(EUV)光刻核心技术体系:辐射发生装置与光刻物镜装调创新解析
在半导体芯片制程向3纳米及以下先进节点迭代的进程中,极紫外(EUV)光刻技术已成为突破传统光刻物理极限、实现超高精度图形转移的核心支撑技术。该技术体系的性能表现由两大核心单元共同决定:一是提供能量源的极紫外辐射发生装置,二是保障成像精度的光刻物镜及其装调工艺。二者的技术突破与协同优化,直接制约光刻精度、光源稳定性及芯片制造良率,是凝聚跨学科技术融合成果的尖端工业产物。
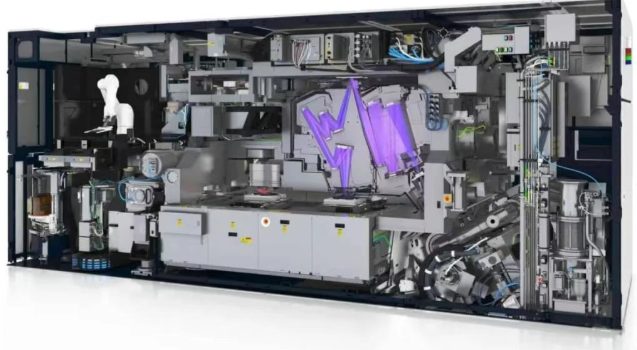
一、极紫外辐射发生装置:EUV光刻的能量核心
极紫外辐射发生装置作为EUV光刻设备的动力核心,通过精密的结构设计与协同工作机制,实现极紫外辐射的高效产生、精准调控与洁净输出,其核心架构以“辐射产生-粒子管控-光收集-废气处理”为核心逻辑链,由六大关键模块构成。
(一)核心模块协同机制
靶材发生器与激光发生器共同构成极紫外辐射的产生源,通过靶材精准发射与高能激光聚焦轰击的时序匹配,实现能量高效转换,产生带电粒子与极紫外辐射。收集器镜采用特种光学涂层与超精密加工工艺,沿光轴高效捕获并反射极紫外辐射,导向后续成像系统。电极板组件通过环状、片状或筒状等多元化排布形成可控强电场,实现带电粒子的约束与分离,避免镜面污染。气控部件与腔体协同构建洁净循环系统,通过氢自由基化学反应转化污染物、惰性气体流场隔离防护的双重设计,保障装置长期稳定运行。腔体则通过优化的进排气布局与极端环境适配设计,为各模块工作提供可靠承载空间。
二、半导体光刻物镜:EUV成像的精度核心
光刻物镜作为光刻机的核心光学元件,其性能直接决定光刻机的线宽与套刻精度,是反映整机技术水平的关键指标。该元件由多枚高精度镜片组成,通常长度超1米、重量超500千克,需满足严苛的性能要求:分辨率达到衍射极限(全视场波前像差均方根≤0.07λ,λ为工作波长),像面弯曲小于几十纳米,畸变控制在几纳米以内,工作波长覆盖KrF、ArF及EUV等紫外波段。
(一)分系统构成
按零部件属性,光刻物镜系统可划分为三大分系统,形成“光学成像-机械支撑-智能控制”的完整架构:
1.光学分系统:包含所有参与投影成像的光学零件,是实现精准图形转移的核心载体;
2.机械分系统:承担光学零件支撑、调节、环境控制与保护功能,同时实现与整机机械结构的可靠连接;
3.控制分系统:由控制机箱、专用软件系统、调节机构及光阑驱动装置组成,为物镜工作提供智能化调控。
(二)装调关键影响因素
光刻物镜装调是保障其性能达标的核心环节,需攻克多重高精度控制难题:
1.精密定位与安装:镜片中心位置与倾斜角度需实现微米级精度控制,依赖高精度机械装置与定位系统完成精准部署;
2.镜片间距调整:通过精密测量仪器实时监测并调整镜片间距,确保光程精准匹配设计要求;
3.光轴共轴控制:保障所有镜片光轴严格共轴,规避像差等成像缺陷;
4.全流程环境管控:装调与工作过程需处于严格环境控制条件下,同时通过水冷装置等散热系统高效管理工作产生的热量;
5.性能闭环校准:通过标准光刻测试图案与专业检测设备,对分辨率、像差、对比度等关键指标进行测量评估,形成“检测-微调-再检测”的闭环优化。
(三)核心装调与检测设备
先进的装调与检测设备是实现光刻物镜高精度要求的关键支撑,目前行业内成熟应用的代表性设备包括:
1.大口径中心偏差测量仪OptiCentric®UP(德国TRIOPTICS研发,由欧光科技提供相关技术支持):作为大口径高负载光学系统的专用装调设备,可广泛应用于半导体光刻物镜、航空航天及天文望远镜等领域。其核心优势包括:0.1μm级超高测量精度;适配球面、非球面、柱面等多种镜片类型,可测量直径0.5mm-800mm的透镜组;支持手动或自动校准、胶合透镜元件,具备非接触式测量功能,可精准检测光学系统空气间隙,实现自动定心与装调一体化操作,同时兼顾偏心测量与镜面间距检测双重需求。
2.研发型高精度光学传递函数测量仪ImageMaster®Universal(欧光科技提供技术方案):适用于半导体光刻物镜、红外光学系统、折转型光路系统等多场景成像质量分析。该设备采用卧式结构设计,支持全自动测量,模块化架构便于运输与维护;基于离轴抛物面反射镜设计的平行光管可实现全波段适配,铝质外壳具备良好的隔光挡风性能;测量精度可溯源至国际标准,软件系统模块化设计且支持脚本自定义测量,结果以标准化报告形式输出,能在宽光谱范围内精准测量各类光学系统参数,覆盖红外、可见光及紫外波段。

三、技术协同与产业价值
极紫外辐射发生装置与光刻物镜装调技术的协同发展,构成了EUV光刻设备的核心技术壁垒。辐射发生装置的高稳定性光源输出,为光刻物镜的精准成像提供了基础条件;而光刻物镜的高精度装调工艺,则最大化发挥了极紫外辐射的超高分辨率潜力。二者的技术突破集中体现了精密制造、光学工程、材料科学、流体力学与智能控制等多学科的深度融合。
随着半导体产业对芯片集成度与性能要求的持续提升,EUV光刻核心技术体系将朝着“更高辐射强度、更高成像精度、更高运行稳定性、更低能耗”的方向演进。极紫外辐射发生装置的结构优化、光刻物镜装调设备的精度升级(如OptiCentric®UP的测量范围拓展、ImageMaster®Universal的检测效率提升),将持续为全球半导体产业向先进制程迭代提供核心技术支撑,推动芯片制造领域的创新突破。
-

光学系统成像质量综合评价体系:波前测试与MTF测试的原理、差异与协同应用
随着精密光学技术在工业精密检测、高端科研仪器、智能视觉成像等领域的深度应用,光学系统的成像质量已成为决定终端产品性能的核心指标。如何建立科学、全面、覆盖研发全流程的成像质量评价体系,是光学系统设计、装调、检测及交付环节的核心命题。当前行业内形成了波前测试与调制传递函数(ModulationTransferFunction,MTF)测试两大主流评价手段,二者从不同维度反映光学系统的性能,并非替代关系,而是构成了从误差诊断到性能验证的完整评价闭环。本文系统梳理两类测试方法的核心原理、技术特征、适用场景及协同应用框架,为光学系统全流程质量管控提供参考
2026-05-28
-

红外镜头高精度双向光学定心装调技术研究
红外镜头是红外探测、光电测量、夜视成像等系统的核心组件,其同轴度精度直接决定系统成像分辨率与测量准确性。针对硅、锗等常用红外光学材料在可见光波段不透过、传统单向光学定心工艺无法完成高精度装调的行业痛点,本文提出一种可见光双向光学定心加工方法。该方法采用180°对置的两台定心仪,同时观测红外透镜两侧的球心像,通过四自由度工装迭代调整透镜位姿,实现透镜光轴与机械旋转轴的高精度重合。实验验证表明,采用该方法装调的长焦红外测量镜头,系统同轴度可达0.02mm以内,焦距相对误差仅为0.2%,成像质量满足高端光学系统指标要求,为红外镜头的批量高精度装调提供了可行的技术路径。
2026-05-28
-

一文看懂轴上色差:镜头中心发虚、带彩边的元凶
很多人用相机、望远镜、显微镜的时候会遇到这种情况:明明对准了焦距,画面中心还是有点模糊,甚至带着淡淡的红/蓝彩色重影,这大概率就是光学里最常见的像差之一——轴上色差(也叫位置色差)在起作用。
2026-05-26
-

高精密标准镜头定心装调技术:车削+计算机辅助的高精度解决方案
随着光学设计技术的成熟,高端光学系统的性能瓶颈已从设计端转向制造与装调端,其中定心精度是决定镜头最终成像质量、分辨力的核心因素。针对紫外OTF测量装置标定用高精密计量标准镜头的严苛定心要求,行业提出了车削加工与计算机辅助装调相结合的全新高精度定心装调技术,可实现光轴倾斜偏差与平移误差的精准控制,满足高精密计量级镜头的装调需求。
2026-05-26
-

高精度光学定心取边加工系统设计与技术解析
高端光学系统的成像质量高度依赖光学元件的同轴度与装配应力控制,光学定心取边(又称定心车削)是实现光机共轴、消除装配误差的核心工艺。本文详细介绍了光学定心取边加工系统的整体架构、工作原理与核心子系统设计方案,阐述了该技术在提升光学装调精度、实现无应力装配方面的核心价值。
2026-05-25








