光刻技术多元化创新:前沿突破与应用拓展
随着半导体制造与光学应用领域对微型化、集成化及低成本化的需求持续攀升,光刻技术作为核心支撑技术,正迎来全方位的创新突破。近期,在极紫外光刻、计算光刻与定向自组装、平面光学元件制造、无掩模光刻及新型材料加工等关键领域,一系列突破性成果相继涌现,为相关产业发展注入强劲动力,也为光子学、传感与精密制造等领域开辟了全新路径。
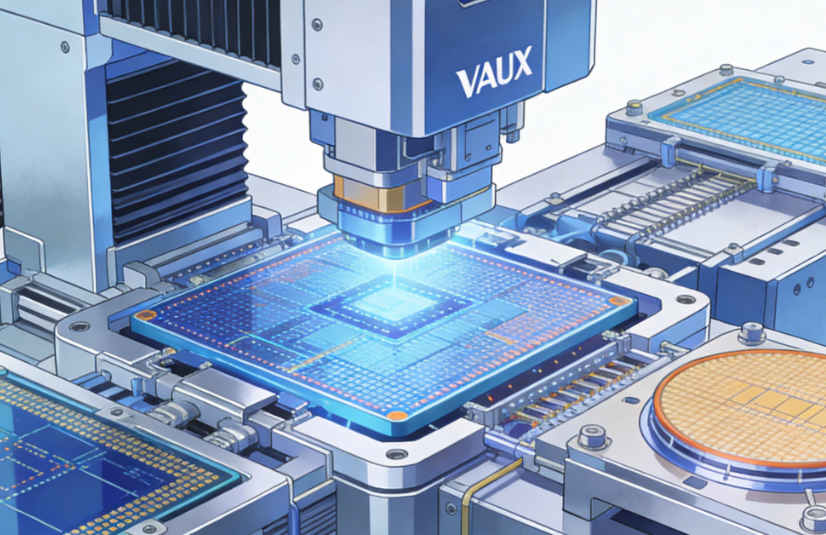
一、极紫外(EUV)光刻:分辨率与能效的双重跨越
EUV光刻作为当前半导体制造的前沿技术,其发展焦点集中于极限分辨率的突破与系统能效的优化,旨在满足先进芯片制造的严苛需求。
在分辨率突破方面,Giannopoulos等人研发的新型EUV反射镜干涉光刻(MIL)技术,实现了光子光刻极限的重大突破。与传统透射光栅不同,该技术借助两束相干光束在平面镜上的反射进行干涉,成功摆脱了光栅衍射效率的限制。在13.5nm波长下,该技术已稳定实现5nm半节距(HP)的线/空图案,更在10.8nm的更短波长下,探索了4nmHP的实现可能性。这一成果有力证明,光子本身并非光刻分辨率的终极瓶颈,同时也为未来光刻胶材料的性能评估搭建了关键实验平台。
在系统能效优化领域,针对传统EUV光刻机电力消耗高昂、六镜光学系统结构复杂的痛点,Shintake提出了简化的双镜EUV投影系统设计。该系统采用轴向对称的两个非球面反射镜(NA0.2),通过两个细长的圆柱形反射镜将光源引入掩模前方,形成平均法向照明,有效减少了掩模3D效应。与传统六镜系统相比,其光功率传输效率提升约13倍,理论上仅需20W的EUV源功率,即可实现每小时100片晶圆的产出,且在20mm视场内能够达成24nm的分辨率。尽管该系统存在中心遮挡问题,但通过优化的离轴四极照明与部分相干光源设计,已实现对遮挡问题的有效规避,并进一步提升了空间分辨率。
二、计算光刻与定向自组装(DSA):现有硬件的性能跃升
为在现有硬件基础上进一步挖掘光刻技术潜力,计算光刻与材料自组装技术的融合创新发挥了关键作用,显著提升了光刻工艺窗口与分辨率水平。
在计算光刻领域,传统曲线全芯片逆向光刻技术(ILT)虽能通过生成曲线掩模大幅扩大光刻工艺窗口,但复杂的曲线图形导致主流可变形状光束(VSB)掩模写入器的写入时间过长,难以满足量产需求。对此,Pang等人提出了全芯片曲线ILT与掩模-晶圆协同优化(MWCO)相结合的解决方案。通过引入MWCO,将优化目标从掩模误差(MaskEPE)转移至晶圆误差(WaferEPE),并采用重叠曝光(OverlappingShots)技术,在保障精度的前提下,显著减少了VSB的曝光次数。这一创新使193i光刻工艺的工艺窗口扩大100%以上,同时将掩模写入时间控制在12小时以内,成功推动曲线掩模进入量产应用阶段。
在定向自组装技术方面,为突破传统嵌段共聚物(如PS-b-PMMA)约11nm的光刻分辨率限制,同时解决高相互作用参数(高-χ)材料难以在薄膜中实现垂直取向的难题,Maekawa等人开发了化学性质精细调控的新型嵌段共聚物系统PS-b-PGFM。通过在PMMA嵌段中引入2,2,2-三氟乙硫醇,该材料的Flory-Huggins相互作用参数较传统PS-b-PMMA提升3.5-4.6倍。在热退火处理下,这种高χ材料形成垂直取向的层状结构,最小域间距仅为12.3nm,且在化学外延导向下,成功制造出7.6nm半节距的线状图案,为亚10nm级光刻图案制备提供了全新方案。
三、平面光学元件:大面积制造技术的革新
光刻技术的创新应用,正推动平面超透镜与衍射元件的大面积制造取得突破性进展,为光学系统的小型化、轻量化革新奠定基础。
Park等人利用DUV投影光刻技术,成功制备出直径达100mm的可见光波段全玻璃超透镜。该制备过程采用步进式光刻机拼接曝光工艺,在熔融石英基底上精准刻蚀187亿个纳米柱,并通过优化的垂直刻蚀工艺消除了侧壁锥度。这款超透镜在632.8nm波长下的焦距为150mm(NA0.32),已成功应用于太阳、月亮及发射星云的拍摄,展现出优异的光学成像性能。
Yamada等人则提出了一种无需刻蚀的简化制造方法,用于制备基于光刻胶的菲涅尔带板(FZP)透镜。该方法采用含有吸光剂的彩色光刻胶(ColorResist),仅通过i-line步进光刻机的涂布、曝光和显影三步流程,即可在8英寸玻璃晶圆上完成FZP透镜的制造。所制备的FZP透镜可将550nm光聚焦至1.1μm直径,聚焦效率达7.2%,且能清晰成像1.1μm特征的物体,具备低成本、大规模生产的显著优势。
四、无掩模光刻与新型光源:灵活高效的技术新路径
无掩模光刻技术凭借其高灵活性,成为快速原型设计的理想选择,而新型光源的研发则为其性能提升提供了核心支撑。
Feng等人开发了用于无掩模光刻的高功率AlGaN基深紫外Micro-LED显示屏。在3μm尺寸的Micro-LED芯片上,实现了5.7%的峰值外量子效率(EQE)和396W/cm²的高亮度。所研制的320×140分辨率微显示屏,能够提供足够的曝光剂量,在数秒内完成光刻胶曝光。该显示屏采用2540ppi的高密度阵列,并结合背部反射层设计,有效提升了出光均匀性与准直性。
为解决光刻过程中光源衰减的问题,Yu等人进一步提出垂直集成的自监测光源架构。该架构在透明蓝宝石衬底的一侧制造DUVMicro-LED阵列,另一侧集成ZnO光电探测器(PD)。LED发出的光穿过衬底后被PD捕获,用于实时监测光功率,结合反馈电路可自动调节注入电流,维持光功率稳定。利用该系统,成功实现了分辨率为564PPI的动态无掩模光刻,为无掩模光刻技术的稳定性提升提供了关键解决方案。
五、新型混合光刻与晶体加工:特殊场景的技术突破
针对特殊结构与材料的加工需求,研究人员开发了一系列独特的混合光刻与加工技术,拓展了光刻技术的应用边界。
Lu等人提出单周期接触-干涉混合光刻技术,用于高效制造微偏振阵列。该技术结合接触式光刻(定义像素区域)与激光干涉光刻(生成亚波长光栅),利用可分离的柔性掩模和折射率匹配液,在单次工艺循环中实现了四个象限不同方向纳米光栅的拼接。通过特殊的对准系统,拼接精度达到亚微米级,所制备的双层金属光栅阵列消光比超过20dB,为微偏振器件的规模化制造提供了高效路径。
Borchers等人则展示了一种利用低功率可见光对有机共晶体进行微加工的“冷光刻”技术。该技术利用偶氮苯染料与挥发性共形成体(如二恶烷或吡嗪)形成的卤键共晶,在0.5-20mW的532nm激光照射下,挥发性成分受热逸出,导致晶体在照射点受控解体,实现“冷”雕刻。与传统高能激光加工相比,该方法不会造成化学损伤,可实现微米级精度的晶体表面图案化,为有机共晶体材料的精密加工提供了全新思路。
六、低成本显微投影光刻:高性价比的纳米加工方案
为满足低成本纳米加工的需求,Zheng等人开发了基于UV-LED的显微投影光刻(MPP)系统。该系统整合商用显微镜组件与365nmUV-LED,配合优化的喷墨打印或激光绘图仪制备的掩模,并通过Tessar透镜校正像差,最终实现了低至85nm的特征尺寸。该系统以其低成本、高性价比的优势,为纳米加工技术的普及应用提供了有力支持
综上所述,当前光刻技术在极高分辨率、大面积制造、智能化与无掩模化及特殊材料加工等方向均取得显著进展。这些技术创新不仅推动了半导体制造工艺的持续升级,更在光子学、传感、精密制造等多个领域拓展了应用场景,为相关产业的高质量发展奠定了坚实基础。未来,随着技术的不断迭代优化,光刻技术将继续突破性能极限,创造更大的产业价值与社会价值。
-

光学定心车削技术在精密显微镜物镜制造中的应用研究
随着生命科学、半导体检测、激光材料加工等领域的快速发展,复杂光学系统对成像性能的要求不断提升,尤其是衍射极限成像能力的实现,对镜头组件装配的对准精度提出了极为严格的微米级要求。传统装配工艺在公差控制、批量一致性等方面存在明显局限,难以满足高数值孔径(NA)物镜的制造需求。本文介绍了一种基于光学定心车削的光机共轴组件(透镜+镜座)精密装配技术,阐述其核心原理、关键设备特性、设计要点,并结合实际应用案例,论证该技术在实现微米级对准、提升产品性能与批量一致性方面的优势,最后对其应用前景进行展望。
2026-04-30
-

群速度色散参数β₂在非线性光学中的核心作用及色散工程技术演进
在非线性光学与超快激光传输领域,群速度色散是决定光脉冲时域演化特性的关键基础物理效应,而群速度色散参数β₂更是划分非线性光学传输特性、决定光脉冲演化命运的核心变量。β₂的正负符号,而非单纯数值大小,将光学传输体系划分为正常色散与反常色散两大截然不同的物理场景,同时也是孤子产生、超连续谱生成、克尔微梳实现等核心非线性应用的设计依据。本文从物理本质、色散分区特性、色散调控原理及工程技术迭代维度,系统阐述β₂的核心价值与应用逻辑。
2026-04-29
-

拉曼光谱技术在多种气体快速检测中的应用
在气体分析领域,快速、精准、高效的检测技术对于工业生产、科研探索等多个领域具有重要意义。拉曼光谱技术凭借其独特的技术优势,在多种气体快速检测中展现出显著的应用价值,为气体分析提供了一种灵活、可靠的全新解决方案。
2026-04-29
-
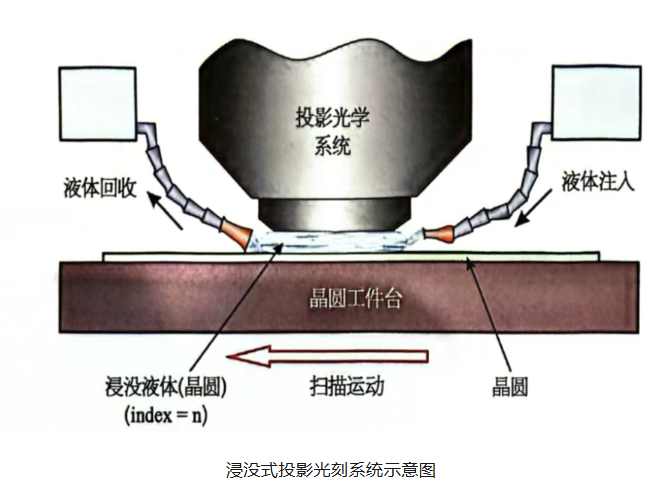
半导体投影光刻核心参数:波长、NA与k₁的技术博弈
半导体芯片制造行业,光刻技术是决定芯片制程精度的核心环节,而波长、数值孔径(NA)和工艺因子k₁,便是调控光刻图形缩放、突破成像极限的三大关键参数。三者协同作用,推动着光刻技术从微米级向纳米级、甚至亚纳米级不断迭代,支撑着半导体产业的持续升级。
2026-04-29
-
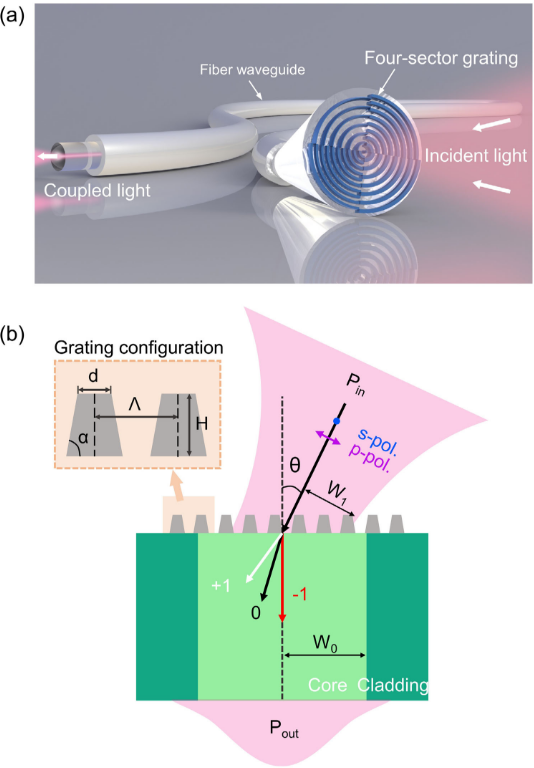
轴向非对称四扇形纳米结构增强光纤尖端:广角光耦合技术的突破性进展
高效的光耦合能力是光纤波导应用中的核心基础,尤其在广角光收集场景中,其性能直接决定了相关设备的应用上限。商用阶跃折射率光纤因耦合系数较低,极大地限制了其在广域内窥镜、随机光子收集等需要大视野光采集的领域中的应用。近期,中国科学院大学杭州高等研究院王宁博士、德国莱布尼茨光子技术研究所MarkusA.Schmidt教授等人开展联合研究,提出了一种基于轴向非对称四扇形纳米结构的光纤尖端增强方案,有效解决了广角光耦合效率低下的行业痛点,相关研究成果发表于国际顶级光学期刊《Laser&PhotonicsReviews》。
2026-04-29