中心偏差测量仪的测量原理科普
在光学测量领域,中心偏差测量仪是一款重要的工具,其在测量透镜的中心偏差时,采用了反射和透射两种不同的模式,每种模式都有着独特的测量原理。

一、反射模式
在反射模式下,测量仪装配有附加镜头的自准直仪会聚焦在透镜的表面曲率中心。这就像是给透镜表面做了一个精准的“定位”。自准直仪发出的光线照到透镜表面后反射回来,通过目镜接收这个反射像。
比如说,如果透镜表面存在倾斜,那么反射回来的像就会明显偏移。就好像我们照镜子,如果镜子倾斜了,我们在镜子里的像也会跟着倾斜和偏移。测量仪通过对这个偏移的精确测量和分析,能够准确计算出透镜表面的中心偏差数值。
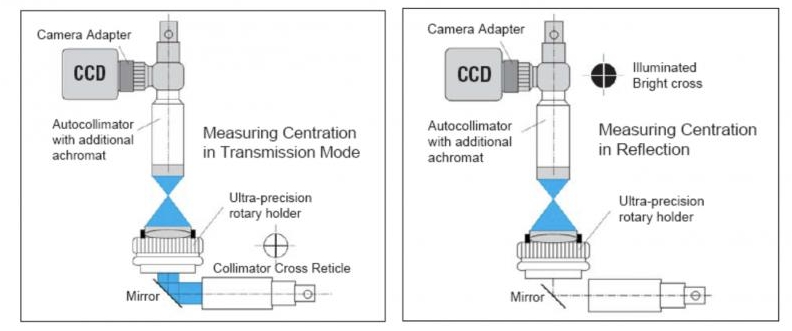
二、透射模式
在透射模式下,情况则有所不同。自准直仪会聚焦在被测透镜的焦平面。这需要一个附加的平行光管来帮忙,平行光管发出平行光束,透过透镜聚焦在焦平面上。
然而,透射模式存在一些局限性。它不能确切地指出是透镜的哪一个表面产生了定心误差。有时甚至会出现奇怪的情况,明明透镜在机械套件内有倾斜,但在透射模式下测量时却显示不存在偏心。
这是因为透射模式的测量结果可能受到多种因素干扰,导致无法清晰地判断偏心的源头和具体状况。
相比之下,反射模式在描绘透镜的倾斜和各自的中心偏差方面更具优势。它能像“放大镜”一样,明确地展示出透镜各表面的真实情况,为精确测量和分析提供了有力的支持。
总的来说,中心偏差测量仪的这两种测量模式各有特点,在不同的应用场景中发挥着重要作用,帮助我们更深入地了解透镜的特性和质量。
-

高精度光学定心取边加工系统设计与技术解析
高端光学系统的成像质量高度依赖光学元件的同轴度与装配应力控制,光学定心取边(又称定心车削)是实现光机共轴、消除装配误差的核心工艺。本文详细介绍了光学定心取边加工系统的整体架构、工作原理与核心子系统设计方案,阐述了该技术在提升光学装调精度、实现无应力装配方面的核心价值。
2026-05-25
-

镜头调制传递函数(MTF)图原理与应用指南
MTF图作为光学镜头性能的量化可视化工具,为镜头的研发测试与用户选型提供了客观统一的参考依据。其核心价值可概括为:10线/mm曲线评估对比度、30线/mm曲线评估分辨率,曲线高度反映绝对性能、平缓度反映画质一致性、双线贴合度反映像散控制水平。在实际应用中,应结合具体使用场景与需求,以MTF图为核心参考,综合多维度性能指标进行镜头选型与性能判断。
2026-05-25
-

突破高端光学装调技术瓶颈!秒级精度镜头轴线定心校准方案解析
传统光学镜头高度依赖人工装调经验,普遍存在装配误差大、成品一致性差、量产效率低、环境适应性弱等问题,长期制约着高端光学设备的国产化量产与性能升级。针对这一行业痛点,西安应用光学研究所团队创新研发出一套秒级精度光学镜头轴线精确定心校准技术体系,通过全流程闭环管控与一体化精密加工工艺,彻底解决光轴偏移、成像误差等核心难题,为高端光学镜头精密制造提供了全新技术路径。
2026-05-25
-

多基准轴透射式离轴光学系统高精度定心装调方法
星载光谱仪可获取空间连续分布的光谱数据,是陆地植被监测、海洋环境探测等领域的核心载荷。为校正分光系统引入的畸变,星载光谱仪成像透镜多采用离轴透射式设计,由此形成的多光轴结构存在大倾角、大偏心特征,超出了传统同轴系统定心装调方法的适用范围。本文提出一种多基准轴定心装调方法(Multi-referenceAxisAlignment,MAA),通过镜筒结构一体化加工预置各光轴的偏心与倾斜参数,结合光学平板实现基准轴的高精度引出,将复杂多光轴系统的装调拆解为多个单光轴子系统的独立装调,突破了传统定心仪的测量范围限制。针对某星载光谱仪3光轴离轴透射系统开展装调验证,实测结果表明,透镜最大偏心误差小于25.4μm,最大倾斜误差小于17.7″,系统实际畸变与理论值平均偏差小于0.32μm,全面满足设计指标要求。该方法为离轴折射类光学系统的高精度装调提供了可行的技术路径,拓展了透射式光学系统装调的适用边界。
2026-05-22
-

平凸透镜朝向对光束会聚效果及像差特性的影响分析
平凸透镜是各类光学系统中应用最为广泛的基础折射元件之一,属于典型的无限共轭透镜,核心光学功能分为两类:一是将点光源出射的发散光束准直为平行光束,二是将入射的准直平行光束会聚至单点。在激光光学、显微成像、光电检测等领域的光路设计与装调中,平凸透镜的安装朝向是直接影响系统性能的核心参数,其选择直接决定了像差水平与最终会聚效果。
2026-05-21








