激光加工与机械加工的对比
激光,全称是受激辐射光放大,英文全称是:Light Amplification by Stimulate Emission of Radiation;缩写为:Laser。它是一种新型光源,具有其他光源无法比拟的相干性、单色性、方向性和高输出功率等特点。

将激光聚焦到一点,焦平面上的功率密度可达105-1013w/cm2.激光焊接利用激光束优良的方向性和高功率密度来进行工作。激光束通过光学系统聚焦在很小的区域上,在很短的时间内,在焊接区域形成能量高度集中的局部热源区域,从而熔化被焊物体,形成牢固的焊点和焊缝。
与传统机械加工相比,激光加工具有以下特点:
1、处理速度快;
2、热变形和热影响区小(适合加工高熔点、高硬度、特殊材料);
3、零件可进行局部热处理;
4、加工形状复杂的零件和微小零件,也可在真空中加工;
5、加工无噪音,对环境无污染;
6、与自动控制和计算机技术相结合,易于实现自动化;
7、由于加工方法先进,可以改进现有的产品结构和材料。
延伸阅读:
激光加工与机械加工在定义、原理和应用方面存在显着差异。
1、激光加工是利用高功率密度激光束照射工件,利用光能的热效应对材料进行焊接、钻孔和切割的工艺过程。基本原理主要是激光热加工和激光冷加工。激光热加工主要是利用激光能量产生的热效应使物体温度升高,引起相变、熔化或汽化等来达到加工目的。主要用于金属或非金属材料的焊接和切割。激光冷加工利用较短波长的激光束引起和控制材料的化学反应,主要用于半导体工业。
2、机械加工是通过机械设备改变工件外部尺寸或性能的过程。根据加工方法不同,可分为切削加工和压力加工,涵盖铸造、锻造、冲压、焊接等多种工艺。机械加工通常在室温下进行,不会引起工件的化学或物理相变,即冷加工。但在某些情况下,也可能在高于或低于正常温度下进行,引起工件发生化学或物理相变,即热处理。
-

柱面镜核心光学参数解析:中心偏差、时钟角与楔角的定义及测量意义
在光学器件制造与光学系统搭建中,柱面镜凭借其单向聚光、成像的光学特性,成为激光加工、光学通信、精密成像等领域的关键元件,其加工精度直接决定整个光学系统的性能上限。中心偏差、时钟角、楔角作为衡量柱面镜加工误差的核心指标,是光学检测的重点关注对象,而德国TRIOPTICS公司的OptiCentric®中心偏差测量仪和技术,为这类参数的精准检测提供了专业解决方案,成为柱面镜质量把控的重要技术支撑。本文将从参数定义、指标特性、测量价值三个维度,对柱面镜的中心偏差、时钟角、楔角进行系统性解析。
2026-03-02
-

光轴校准后镜座加工工序规范
光轴校准作为镜片-镜座组合体加工过程中的关键前置环节,其校准精度直接决定后续加工质量与产品最终性能。本次镜座加工工序依托ACL定心车(卧式光学定心车床)完成,该设备是专为透镜定心加工研发的高精度专用机床,核心功能是通过加工光学透镜所在的金属镜座,使光学件的光轴与金属镜座机械轴精准重合,进而装配出接近理想状态的镜头组,同时保障镜座结构尺寸精度,满足后续装配的公差要求,具备高精度、高效率、高性价比及高灵活性的核心优势,广泛应用于镜头加工、激光校准等领域,可适配红外镜片、非球面透镜等多种镜片及组合体的加工需求,还能灵活应对批量生产与定制化加工场景。
2026-03-02
-

旋转扫描法的原理解析
旋转扫描法是光学元件偏心检测领域的核心高精度方法,也是中测光科ACL卧式数控定心车床实现镜片光轴与机械镜座机械轴精准对心的关键技术,其以机械旋转基准为依托,结合光学反射光路变化规律,通过“运动扫描-信号采集-数据换算”的标准化逻辑,实现微米级的偏心量、光轴倾斜角度量化检测,为光学元件精密加工与光学系统装配提供精准数据支撑。该方法的原理可从核心设计逻辑、理论原理、实操检测流程,以及实际应用中的光路适配设计四个维度逐层拆解,逻辑上遵循“基准确立-原理支撑-落地执行-场景适配”的完整体系。
2026-03-02
-
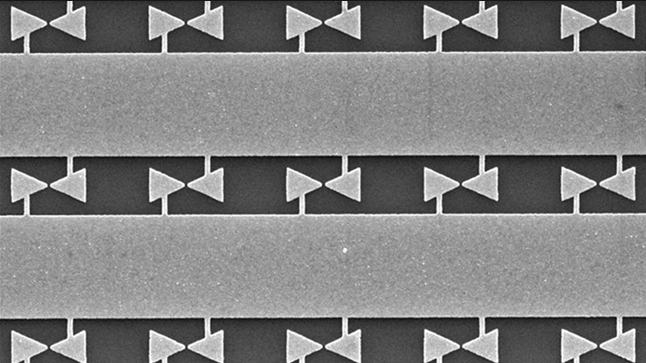
量子点领结结构实现红外光源重大突破:效率提升百倍,制造工艺大幅简化
2026年2月,芝加哥大学研究团队在《NaturePhotonics》发表重要成果,通过量子点材料与领结型微纳结构的创新结合,开发出一种高效、简易的红外光产生技术,其光电转换效率较传统方案提升约100倍,有望大幅降低红外光源、探测器及相关系统的成本与制造门槛。
2026-02-27