什么是硅光通信芯片共封装(CPO)技术?为什么说它是数据中心通信的变革驱动力
一、光通信技术:从理论奠基到全场景渗透的技术演进
1966年,高锟博士提出的低损耗光纤理论,为光通信技术构建了基础物理框架。光纤通信凭借带宽大、传输损耗低、通信距离长、信息容量大及抗电磁干扰能力强等显著优势,迅速取代铜线、无线等传统传输介质,成为数字通信领域的核心技术形态。
20世纪90年代初,掺铒光纤放大器(EDFA)与波分复用器(WDM)的发明,突破了长距离高速传输的技术瓶颈,使光通信系统的传输容量呈指数级增长。当前,光通信技术已全面覆盖广域网(WANs)、城域网(MANs)、局域网(LANs)及接入网(ANs)等场景,光纤到户(FTTH)技术亦在全球范围内实现规模化部署。
在人工智能、大数据、工业互联网等新兴技术的驱动下,全球数据流量呈现爆发式增长态势,预计至2025年将达到175Zettabyte。数据中心作为数据处理与交换的核心节点,对高速通信的需求日益迫切。然而,短距离通信中电互联技术受限于物理极限(单通道电互联速率<25Gb/s),且功耗问题显著,以光互联替代电互联成为提升通信带宽的必然选择,数据中心光收发模块正向800Gbit/s及以上速率的传输能力演进。
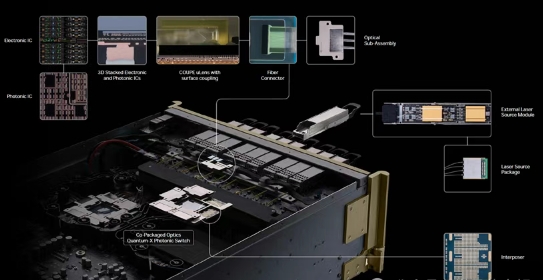
二、数据中心架构:光通信技术的分层应用体系
数据中心叶脊架构(Splineleaf)包含机柜层、Leaf层与Spline层三个层级,各层级对光通信的技术要求呈现差异化特征:
机柜层:作为网络架构的底层,主要承担服务器互联功能,通过顶层交换机(ToR)实现设备连接,传输带宽需求为200G,通信距离覆盖420米范围。
Leaf层:由叶交换机构成,承担承上启下的关键作用,实现与ToR交换机及Spline交换机的互连,传输速率要求达800G,典型传输距离为100米(短距离,SR)。
Spline层:作为数据中心的顶层架构,一方面负责内部SplineLeaf层互连,传输带宽800G,传输距离2千米(长距离,FR);另一方面支撑数据中心间(DCI)互连,通信距离延伸至80120千米(超长途,ZR),通常采用密集波分复用技术或相干光模块实现信号传输。
三、光子集成芯片材料:多元技术路线与混合集成趋势
光子集成芯片(PICs)通过片上光学网络系统集成,结合CMOS兼容工艺,实现了规模化生产与成本控制。然而,材料体系的多样性制约了技术标准化进程,当前主流材料平台的技术特性如下:
硅光子(SiPh)平台:以硅为波导芯层,凭借高折射率差实现紧凑结构设计,与CMOS工艺兼容,适合大规模集成。但受限于间接带隙特性,无法集成光源与光放大器,且缺乏线性电光效应,高速调制器与高效光电探测器的制备存在技术瓶颈。
磷化铟(InP)平台:作为直接带隙半导体材料,可实现激光器、调制器、探测器及光放大器的单片集成。但波导折射率差小导致器件尺寸较大,且与CMOS工艺不兼容,制造成本较高,难以满足大规模集成需求。
铌酸锂(LiNiO₃)平台:基于线性电光效应的调制器制备技术成熟,但传统体材料结构尺寸达厘米级,集成难度大。绝缘体上铌酸锂技术虽提升了集成度,但加工工艺复杂,成本居高不下。
二氧化硅平面光波导(PLC)平台:唯一实现商业化应用的材料体系,具有极低传输损耗与高效光纤耦合能力,但热光系数低且无电光效应,功能调谐能力受限。
聚合物平面光波导平台:以SU8等聚合物为芯层材料,热光系数适配低功耗器件设计,且具备材料可定制特性,在多功能集成(如电光调制、生物传感)领域展现出潜力。
鉴于单一材料平台难以满足全功能集成需求,混合集成技术成为突破瓶颈的重要解决方案,通过异质材料键合实现光源、调制器、探测器等功能单元的协同优化。
四、硅光调制器制备:标准化工艺流与技术突破
代工厂普遍提供多项目晶圆(MPW)、定制化开发与批量生产三类服务模式。以新加坡AMF公司硅光子平台为例,其工艺基于200mmCMOS标准流程,具体包括:
衬底结构:硅衬底厚度750μm,电阻率>750Ω·cm;氧化物埋层(BOX)厚度3μm;顶层硅厚度220nm。
刻蚀工艺:首次刻蚀70nm形成光栅耦合器结构,二次刻蚀60nm制备90nm厚度的脊波导平板。
离子注入:依次完成P++、N++、P+、N+、P、N区域的离子注入,其中P型掺杂采用硼元素,N型掺杂采用磷元素。
金属互连:通过通孔(Via1/2)与金属层(Metal1/2)实现欧姆接触,其中Via1高度600nm,Metal1厚度750nm;Via2高度1310nm,Metal2厚度2000nm,材料均为铝。
所制备的硅基电光调制器(如DDMZM、SPPMZM)采用2mm长度调制臂与非对称MZM结构,行波电极末端集成35Ω钛nitride(TiN)匹配电阻,后续可通过对称结构设计优化波长敏感性。
五、硅光技术封装:三维集成架构与CPO技术展望
面对二维集成的规模限制,三维光子集成技术通过光通孔(TSOV)实现多层芯片互连,相较于层内波导交叉,层间光学隔离可显著降低传输损耗与串扰。典型案例为220nmSOI光芯片与65nmCMOS电芯片的晶圆键合工艺,通过分工艺流制备与异质集成,降低了单片工艺复杂度,提升了生产效率与成本效益。
在超高速通信场景下,基于板载光学(OBO)的可插拔光模块面临1.6T后的技术瓶颈,共封装光学(CPO)技术成为破局关键。该技术通过中介层(Interposer)实现交换芯片(ASIC)与光子引擎的协同封装,大幅缩短信号链路长度,降低传输损耗。随着3D集成技术与异构封装工艺的成熟,CPO技术将在提升通信带宽密度、优化能量效率等方面发挥核心作用,成为下一代数据中心通信架构的核心支撑技术。
硅光通信芯片共封装技术通过材料创新、工艺优化与架构革新,构建了数据中心高速通信的技术体系。随着混合集成、三维封装等技术的持续突破,该技术将进一步推动信息基础设施向高带宽、低功耗、高密度集成方向演进,为全球数字化转型提供关键技术支撑。
-

多基准轴透射式离轴光学系统高精度定心装调方法
星载光谱仪可获取空间连续分布的光谱数据,是陆地植被监测、海洋环境探测等领域的核心载荷。为校正分光系统引入的畸变,星载光谱仪成像透镜多采用离轴透射式设计,由此形成的多光轴结构存在大倾角、大偏心特征,超出了传统同轴系统定心装调方法的适用范围。本文提出一种多基准轴定心装调方法(Multi-referenceAxisAlignment,MAA),通过镜筒结构一体化加工预置各光轴的偏心与倾斜参数,结合光学平板实现基准轴的高精度引出,将复杂多光轴系统的装调拆解为多个单光轴子系统的独立装调,突破了传统定心仪的测量范围限制。针对某星载光谱仪3光轴离轴透射系统开展装调验证,实测结果表明,透镜最大偏心误差小于25.4μm,最大倾斜误差小于17.7″,系统实际畸变与理论值平均偏差小于0.32μm,全面满足设计指标要求。该方法为离轴折射类光学系统的高精度装调提供了可行的技术路径,拓展了透射式光学系统装调的适用边界。
2026-05-22
-

平凸透镜朝向对光束会聚效果及像差特性的影响分析
平凸透镜是各类光学系统中应用最为广泛的基础折射元件之一,属于典型的无限共轭透镜,核心光学功能分为两类:一是将点光源出射的发散光束准直为平行光束,二是将入射的准直平行光束会聚至单点。在激光光学、显微成像、光电检测等领域的光路设计与装调中,平凸透镜的安装朝向是直接影响系统性能的核心参数,其选择直接决定了像差水平与最终会聚效果。
2026-05-21
-

光机系统设计:镜头装配轴向预紧力计算(一)——通用设计原则与基础方法
本文基于光机系统设计领域的经典工程理论,系统阐述镜头装配中透镜面接触安装技术的核心原理,明确轴向预紧力在透镜固定、精度保持与环境适应性中的关键作用,详细介绍标称轴向预紧力的基础计算方法、参数定义与适用边界,同时解析轴向预载对透镜自动定心、抗径向偏心的力学效应,为光学镜头的装调设计提供标准化的工程参考。
2026-05-21
-

高精度轴对称非球面反射镜面形轮廓非接触式测量方法
非球面光学元件是高端光学系统的核心器件,其面形轮廓的高精度、可溯源测量是保障加工质量与系统性能的关键。本文针对轴对称非球面反射镜的测量需求,建立了通用化的非球面扫描轨迹数学模型,提出一种基于独立计量回路的非接触式坐标扫描测量方法。该方法采用运动与计量分离的框架结构,有效隔离运动误差对测量结果的影响;测头采用集成阵列式波片的四象限干涉测量系统,实现1nm级测量分辨率;通过扫描执行机构与多路激光干涉系统共基准设计,实现测量值可溯源至“米”定义。试验验证表明,该方法测量误差小于0.2μm,重复性精度达70nm,整体测量精度达到亚微米级,为非球面测量的量值统一与溯源提供了成熟的技术方案。
2026-05-21
-

麻省理工学院固态激光雷达硅光子芯片核心突破解读
麻省理工学院研究团队攻克了硅光子集成光学相控阵(OPA)固态激光雷达的长期核心瓶颈,通过创新的低串扰集成天线阵列设计,首次实现了宽视野扫描+低噪声高精度的无活动部件激光雷达芯片,为下一代紧凑、高耐用性固态激光雷达的落地奠定了技术基础。
2026-05-20








