一文读懂光学镜片精磨后光圈数的设定与影响因素
在光学镜片制造领域,精磨环节至关重要,而精磨后的光圈数更是决定镜片质量的关键因素。

在进行球面前的散粒磨料精磨时,准备工作不容小觑。一套配备不同粒度磨料、具有各异半径的球模是必备“武器”。精磨机上的镜盘与球模放置方式也有讲究,通常凹在上凸在下,但遇到凸镜盘光圈过高且半径不大的情况,将凸镜盘反转放置,此时镜盘后方需接把,确保从铁笔孔到球面的距离大于2R,以维持左右摇摆的稳定性。这一细节调整,充分体现了光学冷加工对精度的极致追求。
磨痕的扩展方向是判断精磨效果的重要依据。当球模修改达标后,无论是凹面还是凸面,磨痕都应从边缘向中心逐渐扩展。在实际操作中,这一过程不仅关乎工件厚度的控制,还影响着镜片表面的毛面质量。依据经验,当磨痕完成从边缘到中心的“封顶”过程,就意味着可以进行换砂和换精磨模的操作了。对于弹性上盘的零件,在精磨第二面前,中心厚度的把控尤为关键,最厚不能超公差上限0.08mm,最薄要大于公差下限0.03mm,这一严格的厚度公差标准,是保证镜片性能的基础。
精磨过程中,不同粒度的砂对镜片的“塑造”效果不同。用第一道砂(Wz)稍磨时,捺贴度从边缘算起为整个镜盘零件的1/2-2/3;用第二道砂(W14)精磨后,擦贴度达到2/3-3/4。而最终精磨后镜片所达到的光圈数,更是有着明确且细致的标准。
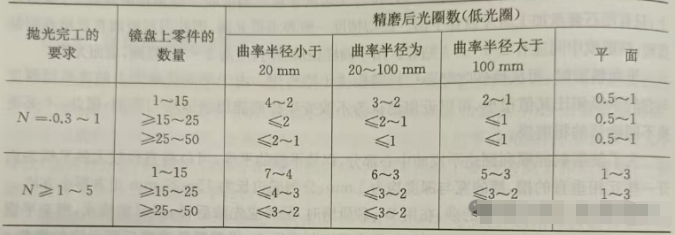
从表格数据来看,光圈数与抛光完工要求、镜盘上零件数量以及镜片曲率半径紧密相关。以抛光完工要求“N=0.3-1”为例,当镜盘上零件数量为1-15时,曲率半径小于20mm的镜片,精磨后光圈数为4-2;曲率半径在20-100mm之间,光圈数为3-2;曲率半径大于100mm,光圈数为2-1;平面镜片光圈数为0.5-1。随着镜盘上零件数量增加、曲率半径变化,光圈数标准也相应改变。这一整套复杂的标准体系,是无数次试验和经验积累的结晶,为光学镜片的批量生产提供了可靠的质量保障。
对于凸透镜,细磨完工后的低光圈状态对后续抛光极为有利。低光圈的具体数量并非随意确定,而是综合考虑最后一道砂的粒度、表面半径、镜盘直径以及玻璃牌号等多种因素。对于表面精度要求较高的球面,最后一道砂磨完后的光圈比抛光完工低1-4道光圈(镜盘表面半径和镜盘直径较大时,光圈差值较小);对于表面精度要求较低的球面,这一差值则在2-7道光圈。这种根据不同需求灵活调整光圈数的方式,既满足了不同应用场景下对镜片的精度要求,又在保证质量的前提下提高了生产效率。
光学镜片精磨后的光圈数,看似只是一组简单的数据,实则背后隐藏着光学冷加工制造的深厚技术积累和严谨工艺规范。从球模准备、磨痕控制到砂的选择、光圈数标准的设定,每一个环节都紧密相连,共同打造出高质量的光学镜片。随着科技的不断发展,光学镜片在各个领域的应用越来越广泛,对镜片质量的要求也日益提高。
-

多基准轴透射式离轴光学系统高精度定心装调方法
星载光谱仪可获取空间连续分布的光谱数据,是陆地植被监测、海洋环境探测等领域的核心载荷。为校正分光系统引入的畸变,星载光谱仪成像透镜多采用离轴透射式设计,由此形成的多光轴结构存在大倾角、大偏心特征,超出了传统同轴系统定心装调方法的适用范围。本文提出一种多基准轴定心装调方法(Multi-referenceAxisAlignment,MAA),通过镜筒结构一体化加工预置各光轴的偏心与倾斜参数,结合光学平板实现基准轴的高精度引出,将复杂多光轴系统的装调拆解为多个单光轴子系统的独立装调,突破了传统定心仪的测量范围限制。针对某星载光谱仪3光轴离轴透射系统开展装调验证,实测结果表明,透镜最大偏心误差小于25.4μm,最大倾斜误差小于17.7″,系统实际畸变与理论值平均偏差小于0.32μm,全面满足设计指标要求。该方法为离轴折射类光学系统的高精度装调提供了可行的技术路径,拓展了透射式光学系统装调的适用边界。
2026-05-22
-

平凸透镜朝向对光束会聚效果及像差特性的影响分析
平凸透镜是各类光学系统中应用最为广泛的基础折射元件之一,属于典型的无限共轭透镜,核心光学功能分为两类:一是将点光源出射的发散光束准直为平行光束,二是将入射的准直平行光束会聚至单点。在激光光学、显微成像、光电检测等领域的光路设计与装调中,平凸透镜的安装朝向是直接影响系统性能的核心参数,其选择直接决定了像差水平与最终会聚效果。
2026-05-21
-

光机系统设计:镜头装配轴向预紧力计算(一)——通用设计原则与基础方法
本文基于光机系统设计领域的经典工程理论,系统阐述镜头装配中透镜面接触安装技术的核心原理,明确轴向预紧力在透镜固定、精度保持与环境适应性中的关键作用,详细介绍标称轴向预紧力的基础计算方法、参数定义与适用边界,同时解析轴向预载对透镜自动定心、抗径向偏心的力学效应,为光学镜头的装调设计提供标准化的工程参考。
2026-05-21
-

高精度轴对称非球面反射镜面形轮廓非接触式测量方法
非球面光学元件是高端光学系统的核心器件,其面形轮廓的高精度、可溯源测量是保障加工质量与系统性能的关键。本文针对轴对称非球面反射镜的测量需求,建立了通用化的非球面扫描轨迹数学模型,提出一种基于独立计量回路的非接触式坐标扫描测量方法。该方法采用运动与计量分离的框架结构,有效隔离运动误差对测量结果的影响;测头采用集成阵列式波片的四象限干涉测量系统,实现1nm级测量分辨率;通过扫描执行机构与多路激光干涉系统共基准设计,实现测量值可溯源至“米”定义。试验验证表明,该方法测量误差小于0.2μm,重复性精度达70nm,整体测量精度达到亚微米级,为非球面测量的量值统一与溯源提供了成熟的技术方案。
2026-05-21
-

麻省理工学院固态激光雷达硅光子芯片核心突破解读
麻省理工学院研究团队攻克了硅光子集成光学相控阵(OPA)固态激光雷达的长期核心瓶颈,通过创新的低串扰集成天线阵列设计,首次实现了宽视野扫描+低噪声高精度的无活动部件激光雷达芯片,为下一代紧凑、高耐用性固态激光雷达的落地奠定了技术基础。
2026-05-20








