激光焊与搅拌摩擦焊在飞机铝合金结构中的应用
在现代航空制造领域,飞机机身的制造对材料连接技术的要求极高,尤其是对于高强铝合金的连接工艺,其直接关系到飞机结构的性能与安全性。激光焊和搅拌摩擦焊作为两种先进的连接技术,已经在飞机机身高强铝合金的连接中得到了成功的应用,并展现出各自独特的性能特点。

一、焊接技术的发展背景
搅拌摩擦焊技术自2015年英国焊接研究所的专利到期后,迎来了装备及技术的快速发展阶段。这一技术的广泛应用不仅局限于飞机制造领域,还拓展到了商业航天等其他高端制造行业,例如一些商业航天的火箭贮箱已经开始采用搅拌摩擦焊技术进行制造,这充分体现了该技术在高性能材料连接方面的巨大潜力和应用价值。
二、微观组织差异
从微观组织的角度来看,激光焊接头的焊缝区(FZ)由于材料经历熔化再凝固的过程,并且冷却速度极快,导致其组织与母材存在较大差异。以AA6013合金为例,其激光焊接头的焊缝区呈现出典型的枝晶结构。这种快速凝固形成的枝晶结构在一定程度上影响了焊接接头的性能。相比之下,搅拌摩擦焊的搅拌区(SZ)则是在固相下通过动态再结晶形成细小等轴晶。以AA6013合金的搅拌摩擦焊接头为例,其搅拌区的组织更加均匀细小,这种细小等轴晶的组织结构使得搅拌摩擦焊接头在微观结构上更接近母材,从而为其优良的力学性能奠定了基础。
三、疲劳性能对比
在疲劳性能方面,两种焊接工艺的接头疲劳强度与传统的铆接工艺相当。例如,激光焊的AA2198-AA2196T型接头疲劳强度可达80MPa,比铆接的AA2024-AA7075接头高出23%。这表明激光焊接头在疲劳性能方面具有一定的优势。然而,激光焊焊缝区由于组织特点和应力集中等因素,相对更容易引发裂纹,而铆接结构则因其特殊的连接方式和应力分布特点,在实际应用中表现出更为稳定的结构性能。
四、接头结构适应性
在接头结构方面,搅拌摩擦焊具有其独特的优势和局限性。它适用于飞机结构中的长距离对接接头或搭接接头,并且能够实现高质量的长距离对接接头。然而,传统的搅拌摩擦焊(FSW)在焊接T型接头内角时,容易对外蒙皮造成损伤。虽然新型的静轴肩搅拌摩擦焊(SSFSW)能够在一定程度上解决这一问题,但在焊接复杂结构和控制公差方面,搅拌摩擦焊仍然面临着一些挑战。相比之下,激光焊接在焊接T型接头时展现出明显的优势。它可以方便地从桁条侧进行焊接,有效避免损伤蒙皮表面,并且能够实现复杂几何形状的焊接。这一特点使得激光焊接在应对新型高强铝合金等复杂结构的焊接需求时,具有更高的适应性和灵活性。
激光焊和搅拌摩擦焊在飞机铝合金结构焊接中各有优劣。激光焊在疲劳性能和复杂结构适应性方面表现出色,但焊缝区易引发裂纹;搅拌摩擦焊则在微观组织均匀性和长距离接头焊接方面具有优势,但在复杂结构焊接和公差控制方面仍需进一步改进。在实际的飞机制造过程中,选择合适的焊接工艺需要综合考虑具体的结构设计、材料特性以及性能要求等因素,以充分发挥每种焊接技术的优势,确保飞机结构的可靠性和安全性。
-

光学定心车削技术在精密显微镜物镜制造中的应用研究
随着生命科学、半导体检测、激光材料加工等领域的快速发展,复杂光学系统对成像性能的要求不断提升,尤其是衍射极限成像能力的实现,对镜头组件装配的对准精度提出了极为严格的微米级要求。传统装配工艺在公差控制、批量一致性等方面存在明显局限,难以满足高数值孔径(NA)物镜的制造需求。本文介绍了一种基于光学定心车削的光机共轴组件(透镜+镜座)精密装配技术,阐述其核心原理、关键设备特性、设计要点,并结合实际应用案例,论证该技术在实现微米级对准、提升产品性能与批量一致性方面的优势,最后对其应用前景进行展望。
2026-04-30
-

群速度色散参数β₂在非线性光学中的核心作用及色散工程技术演进
在非线性光学与超快激光传输领域,群速度色散是决定光脉冲时域演化特性的关键基础物理效应,而群速度色散参数β₂更是划分非线性光学传输特性、决定光脉冲演化命运的核心变量。β₂的正负符号,而非单纯数值大小,将光学传输体系划分为正常色散与反常色散两大截然不同的物理场景,同时也是孤子产生、超连续谱生成、克尔微梳实现等核心非线性应用的设计依据。本文从物理本质、色散分区特性、色散调控原理及工程技术迭代维度,系统阐述β₂的核心价值与应用逻辑。
2026-04-29
-

拉曼光谱技术在多种气体快速检测中的应用
在气体分析领域,快速、精准、高效的检测技术对于工业生产、科研探索等多个领域具有重要意义。拉曼光谱技术凭借其独特的技术优势,在多种气体快速检测中展现出显著的应用价值,为气体分析提供了一种灵活、可靠的全新解决方案。
2026-04-29
-
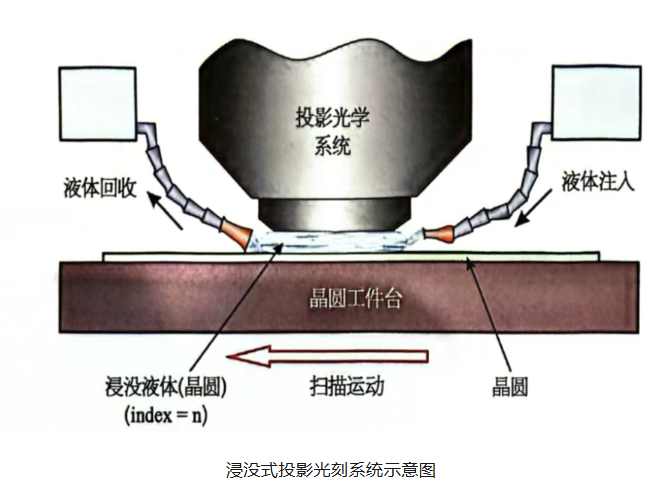
半导体投影光刻核心参数:波长、NA与k₁的技术博弈
半导体芯片制造行业,光刻技术是决定芯片制程精度的核心环节,而波长、数值孔径(NA)和工艺因子k₁,便是调控光刻图形缩放、突破成像极限的三大关键参数。三者协同作用,推动着光刻技术从微米级向纳米级、甚至亚纳米级不断迭代,支撑着半导体产业的持续升级。
2026-04-29
-
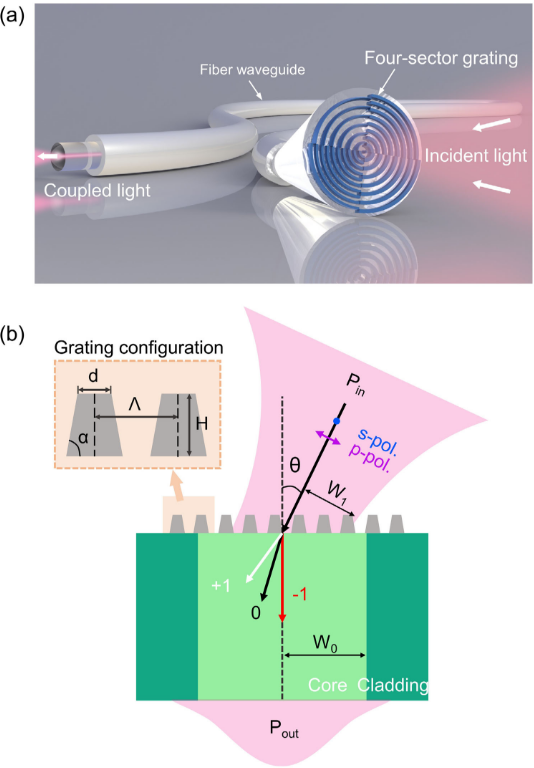
轴向非对称四扇形纳米结构增强光纤尖端:广角光耦合技术的突破性进展
高效的光耦合能力是光纤波导应用中的核心基础,尤其在广角光收集场景中,其性能直接决定了相关设备的应用上限。商用阶跃折射率光纤因耦合系数较低,极大地限制了其在广域内窥镜、随机光子收集等需要大视野光采集的领域中的应用。近期,中国科学院大学杭州高等研究院王宁博士、德国莱布尼茨光子技术研究所MarkusA.Schmidt教授等人开展联合研究,提出了一种基于轴向非对称四扇形纳米结构的光纤尖端增强方案,有效解决了广角光耦合效率低下的行业痛点,相关研究成果发表于国际顶级光学期刊《Laser&PhotonicsReviews》。
2026-04-29