【半导体资讯】香港科技大学等机构合作开发出深紫外微型LED光刻机
光刻机是半导体制造的核心设备,它利用短波长紫外光在硅片上曝光光刻胶膜,制造出具有复杂电路布局的芯片。然而,传统的汞灯和DUVLED光源存在诸多不足,如器件尺寸大、分辨率低、能耗高、光效率低和光功率密度不足等,限制了光刻机的性能和应用范围。为了克服这些挑战,香港科技大学、南方科技大学和中国科学院苏州纳米技术研究所联合开展研究,成功开发出一种深紫外(DUV)微型LED显示器阵列,用于光刻机制造,这标志着在半导体设备自主研发领域迈出了关键一步.

一、研究成果与创新点
1.世界上第一个增强效率的DUV微型LED:该微型LED通过提供足够的光输出功率密度,在更短的时间内曝光光刻胶膜,展示了低成本无掩模光刻的可行性,相较于传统光源,显著提高了光刻效率.
2.无掩模光刻原型平台的构建:研究团队利用该平台,通过使用无掩模曝光的DUV微型LED制造了第一个微型LED器件,这一创新方法简化了光刻流程,降低了生产成本,同时提高了生产过程中的光提取效率、热分布性能和外延应力消除,为半导体制造提供了新的技术路径.
3.优异的器件性能:制成的DUV微型LED具有高功率、高光效、高分辨率图案显示、提升屏幕性能、快速曝光能力等特点。其器件尺寸更小、驱动电压更低、外量子效率更高、光功率密度更高、阵列尺寸更大、显示分辨率更高,这些关键性能指标均处于全球领先地位,相较于其他代表作品具有显著优势.
二、研究影响与未来展望
1.推动半导体设备自主研发:这项工作为我国在半导体设备领域的自主研发提供了重要技术支持,有助于打破国外技术垄断,提升我国半导体产业的自主创新能力,增强在全球半导体市场的竞争力.
2.促进无掩模光刻技术发展:无掩模光刻技术因可调整曝光图案、提供更大的定制化空间、节省光刻胶制备成本等特点,近年来受到了广泛的研究关注。该研究的成功将推动无掩模光刻技术的进一步发展和应用,为半导体制造带来新的变革.
3.拓展应用领域:除了在半导体制造中的应用,该DUV微型LED技术还有望在其他需要高精度曝光的领域发挥重要作用,如微纳加工、生物医疗、显示技术等,具有广阔的应用前景.
未来,该研究团队计划继续提升铝镓氮化物DUV微型LED的性能,改进原型,并开发2k至8k高分辨率DUV微型LED显示屏,以满足更高精度和更大规模的光刻需求,进一步推动半导体制造技术的进步和相关产业的发展.
-

光学定心车削技术在精密显微镜物镜制造中的应用研究
随着生命科学、半导体检测、激光材料加工等领域的快速发展,复杂光学系统对成像性能的要求不断提升,尤其是衍射极限成像能力的实现,对镜头组件装配的对准精度提出了极为严格的微米级要求。传统装配工艺在公差控制、批量一致性等方面存在明显局限,难以满足高数值孔径(NA)物镜的制造需求。本文介绍了一种基于光学定心车削的光机共轴组件(透镜+镜座)精密装配技术,阐述其核心原理、关键设备特性、设计要点,并结合实际应用案例,论证该技术在实现微米级对准、提升产品性能与批量一致性方面的优势,最后对其应用前景进行展望。
2026-04-30
-

群速度色散参数β₂在非线性光学中的核心作用及色散工程技术演进
在非线性光学与超快激光传输领域,群速度色散是决定光脉冲时域演化特性的关键基础物理效应,而群速度色散参数β₂更是划分非线性光学传输特性、决定光脉冲演化命运的核心变量。β₂的正负符号,而非单纯数值大小,将光学传输体系划分为正常色散与反常色散两大截然不同的物理场景,同时也是孤子产生、超连续谱生成、克尔微梳实现等核心非线性应用的设计依据。本文从物理本质、色散分区特性、色散调控原理及工程技术迭代维度,系统阐述β₂的核心价值与应用逻辑。
2026-04-29
-

拉曼光谱技术在多种气体快速检测中的应用
在气体分析领域,快速、精准、高效的检测技术对于工业生产、科研探索等多个领域具有重要意义。拉曼光谱技术凭借其独特的技术优势,在多种气体快速检测中展现出显著的应用价值,为气体分析提供了一种灵活、可靠的全新解决方案。
2026-04-29
-
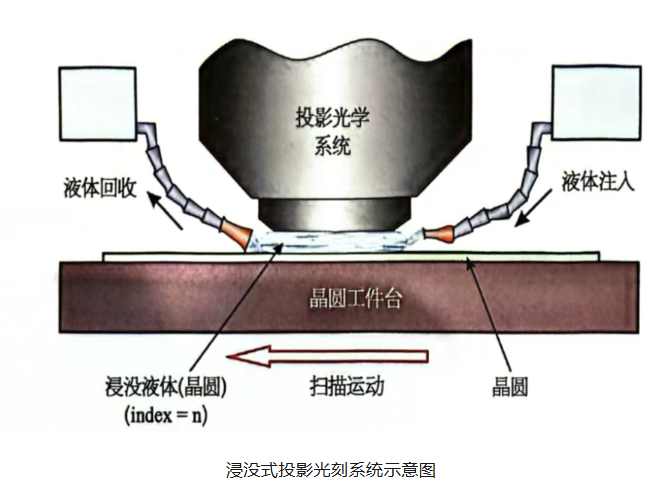
半导体投影光刻核心参数:波长、NA与k₁的技术博弈
半导体芯片制造行业,光刻技术是决定芯片制程精度的核心环节,而波长、数值孔径(NA)和工艺因子k₁,便是调控光刻图形缩放、突破成像极限的三大关键参数。三者协同作用,推动着光刻技术从微米级向纳米级、甚至亚纳米级不断迭代,支撑着半导体产业的持续升级。
2026-04-29
-
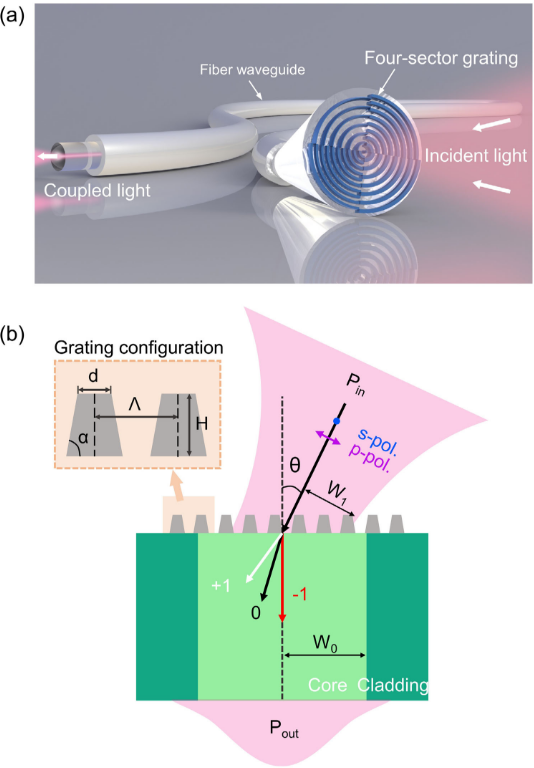
轴向非对称四扇形纳米结构增强光纤尖端:广角光耦合技术的突破性进展
高效的光耦合能力是光纤波导应用中的核心基础,尤其在广角光收集场景中,其性能直接决定了相关设备的应用上限。商用阶跃折射率光纤因耦合系数较低,极大地限制了其在广域内窥镜、随机光子收集等需要大视野光采集的领域中的应用。近期,中国科学院大学杭州高等研究院王宁博士、德国莱布尼茨光子技术研究所MarkusA.Schmidt教授等人开展联合研究,提出了一种基于轴向非对称四扇形纳米结构的光纤尖端增强方案,有效解决了广角光耦合效率低下的行业痛点,相关研究成果发表于国际顶级光学期刊《Laser&PhotonicsReviews》。
2026-04-29